
Bevor aus Silizium Halbleiter-Chips entstehen, sind viele Prozessschritte notwendig. Zunächst werden aus einem kristallinen Silizium-Ingot etwa 1mm dünne Scheiben geschnitten, die anschließend geläppt werden. Dabei erhalten sie die gewünschte Dicke und Oberflächengüte. Erst dann können aus den Wafern mit weiteren Verfahren Halbleiter-Chips gefertigt werden.
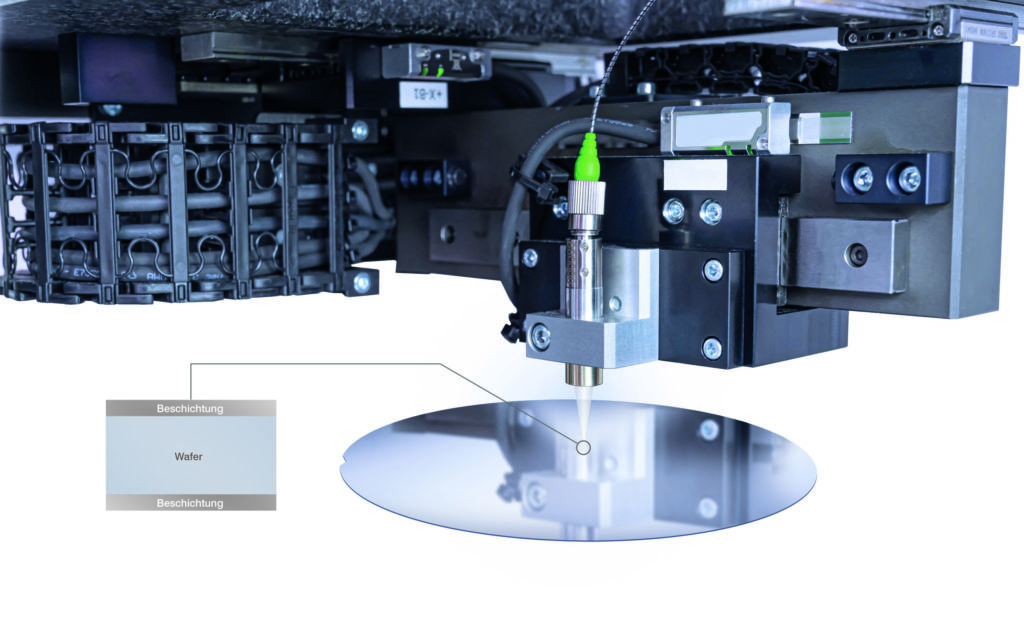
Läppvorgang überwachen
Mit modernen Läppmaschinen lassen sich die Oberflächen extrem genau bearbeiten. Bei Silizium-Wafern sind Ungenauigkeiten der Oberfläche im Nanometer-Bereich notwendig. Dazu wird zwischen Läppscheibe und Wafer ein Gemisch aus Flüssigkeit und Schneidkörnern gebracht, welche die Oberfläche spanend bearbeiten. Dadurch dass sich Läppscheibe und die Wafer gegeneinander um unterschiedliche Achsen drehen, wird Material abgetragen und die Oberfläche geglättet. Um die geforderten Genauigkeiten bei Oberflächengüte und Dicke zu erreichen, muss die Dicke des Wafers gemessen werden. Idealerweise passiert dies während des Verfahrens, das sich dadurch auf Basis der Messwerte exakt steuern lässt. Eine Messmethode, die Dickenmessungen mit Genauigkeiten im Nanometerbereich ermöglicht, ist die Interferometrie.
Um die Interferometrie als messtechnische Verfahren einzusetzen, wird ein Lichtstrahl aufgeteilt, sodass die beiden Teilstrahlen unterschiedliche Wege zurücklegen. Anschließend werden die Teilstrahlen überlagert, und die entstehende Interferenz wird beobachtet. Wenn sich nun die Länge einer der beiden Teilstrahlen ändert, ist dies im Interferenzmuster sichtbar. Ändert sich diese Länge um eine halbe Wellenlänge des verwendeten Lichts, so führt das zu einem kompletten Wechsel von konstruktiver Interferenz zu destruktiver Interferenz. Soll das Verfahren zur Dickenmessung eingesetzt werden können die beiden Strahlen miteinander interferieren, die von der Vorder- und der Rückseite der Schicht reflektiert wird. Dadurch ist das Messergebnis gleichzeitig unabhängig vom Abstand zum Messobjekt.
Weißlicht-Interferometer
Die Interferenz, so wie sie oben beschrieben wurde, funktioniert mit monochromatischem Licht – beispielsweise aus einem Laser. Bei Änderung der gemessenen Länge wechselt das Interferenzmuster abwechselnd von Hell zu Dunkel. Prinzipiell funktioniert Interferometrie aber auch mit weißem Licht. Wichtig ist lediglich, dass eine kohärente Lichtquelle verwendet wird. Für die Weißlicht-Interferometrie eignen sich etwa Superlumineszenz-Dioden (SLD). Diese kombinieren die Vorteile von Laserdioden und herkömmlichen LED. SLD haben eine hohe Ausgangsleistung und gleichzeitig ein breites Spektrum. Micro-Epsilon bietet Interferometer an, die mit solchen SLD arbeiten. Der Lichtstrahl wird geteilt, die Teilstrahlen durchlaufen die beiden Wege und interferieren danach. Für die Messung wird das interferierende Licht zunächst in seine spektralen Bestandteile aufgespalten und anschließend auf eine Sensorzeile abgebildet, die das gesamte Spektrum aufnimmt. Zur Auswertung dieses Signals wird dann eine Fouriertransformation durchgeführt. Die einzelnen Peaks im Frequenzspektrum stehen dann für eine konstruktive Interferenz, woraus sich die Differenz der beiden Wege ergibt. Wenn die beiden Teilstrahlen durch Reflektion an der Vorder- und Rückseite eines transparenten Materials entstehen, wird so die Dicke mit hoher Genauigkeit bestimmt.